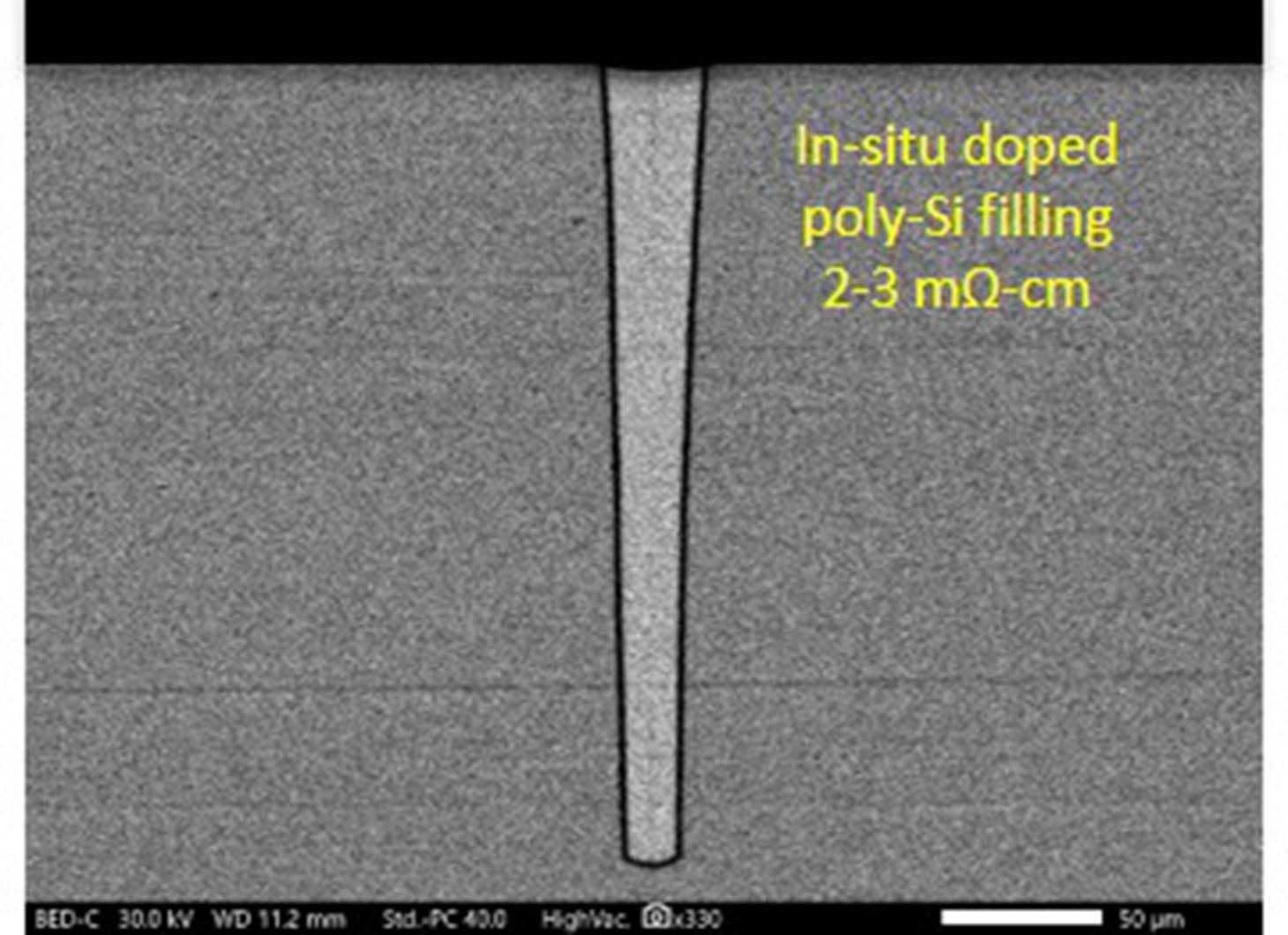
TSV硅片:硅通孔技术
使用多晶硅填充TSV,Okmetic的硅片可实现MEMS的三维集成和先进的晶圆级封装。我们的TSV蚀刻在双抛片(DSP)上,随后在设备制造商处通过背面研磨的工艺显露出来。
Okmetic的多晶硅填充TSV可以实现通过硅片的电隔离连接,这有助于减小MEMS器件的裸片尺寸,并实现了层间的电互连和MEMS的三维集成。在谐振器和惯性传感器等传感器应用中,我们的TSV硅片用作中介层和封帽硅片。
Okmetic 的TSV硅片有助于减小MEMS器件的裸片尺寸,并实现了层间的电互连和MEMS的三维集成
Okmetic的TSV硅片采用先通孔(Via-First)的方式制造——先在双面抛光片上蚀刻,再使用热氧化物绝缘层和原位掺硼多晶硅填充的通孔/沟槽作为互连材料。按照这种方法,TSV在早期阶段就可以集成到硅片上,设备制造商只需在后续工艺中通过背面研磨或其他硅片减薄方法将其显现出来。在不经填充的情况下也可以使用TSV技术,以便设备制造商根据其特定要求选择填充通孔。
带有硅通孔的双抛片也可与绝缘体上硅片相结合。客户可以使用常用的阳极、金属或玻璃熔块键合的方式将TSV硅片与其他晶圆相键合。
TSV硅片和C-SOI®硅片的组合
传感器的晶圆级封装须要通孔垂直互连技术,以便使用标准的倒装芯片组装工艺。在最先进的MEMS生产中,腔体型SOI(C-SOI®)硅片通过键合与TSV硅片相结合。这大大简化了晶圆级封装和异构芯片的集成,因此实现了更小的裸片尺寸和更具成本效益的封帽和组装工艺流程。
更小的裸片尺寸和简化的集成工艺
Okmetic使用多晶硅填充的TSV硅片适用于高温的工艺,其洁净度完全符合CMOS的制造标准。多晶硅通孔只含有硅和热二氧化硅,其众所周知的材料特性使得硅通孔坚固耐用且易于集成。客户可以使用金属互连和凸点,在键合和减薄后与多晶硅通孔建立电气互连。凭借其均匀的电阻率、低通孔电阻和电容,多晶硅通孔在MEMS器件中表现出卓越的性能。
在MEMS设备中展现的性能:
- 硅片之间以及硅片内的均匀电阻率(<5%)
- 电阻10-15欧姆(直径为30微米、厚度为200微米)
- 电容<5pF(2微米热氧化物绝缘层)
- 漏电流<5pA@100V(2微米热氧化物)
按需定制的TSV硅片设计

Okmetic的TSV蚀刻在双面抛光的硅片(DSP)上,厚度的均匀性和晶向的准确率都很出色,同时其晶体质量和同质性也是一流的。我们经验丰富的销售和技术支持很乐意帮助客户找到最佳的解决方案,就 TSV 硅片的具体细节进行进一步磋商,譬如硅片厚度、通孔尺寸、间距、电阻率、电容、布局和隔离电阻等。
用于TSV技术的双抛片(DSP)规格
| 晶体生长方式 | Cz, MCz, A-MCz® |
| 直径 | 200 mm, 150 mm |
| 晶向 | <100>、<110>、<111>、偏向 |
| N型掺杂剂 | 锑、磷 |
| P型掺杂剂 | 硼 |
| 电阻率1 | 从<0.001到>7000欧姆-厘米 |
| 厚度2 | 625微米到1150微米 |
| 厚度公差3 | ±5微米 |
| TTV | <1微米或 ≤0.7微米 |
| 双抛片晶向准确度4 | ±0.2° |
| SFQR | ≤0.2微米 |
2 在一定限制条件下可实现其他厚度。
3 对于要求严苛的器件有±3微米的容差。
4 对于要求严苛的器件有±0.15°的精度。
完全兼容CMOS晶圆表面质量和清洁度要求。
TSV设计
| 宽度 | 7至30微米 |
| 长度 | >2倍宽度 |
| 深度 | <250微米 |
| 纵横比 | <10 |
| 通孔密度 | <20个/平方毫米 |
| 隔离氧化层厚度 | 0.5…2.0微米 |
| 通孔凹陷 | <0.5微米 |
| 通孔电阻率 | <5毫欧-厘米(原位掺硼多晶硅) |