
C-SOI®硅片:埋层腔体型SOI
Okmetic的C-SOI®硅片是一种键合SOI硅片,在衬底层或埋氧层上内置密封腔。C-SOI®硅片代表了最先进的硅基衬底技术,与其说是硅片,它可以被视为一类传感器结构或是一种电子器件。这种硅片的好处是毋庸置疑的:更精简且更具成本效益的器件制造,能够满足更复杂的设备设计需求。
Okmetic的C-SOI®硅片是一种键合腔体绝缘体上硅片,在键合和减薄作为器件层的上层硅片之前,在底部硅片或在埋氧(BOX)层上蚀刻内置的密封腔图案。Okmetic可以在上层的器件层上制备自定义对准标记,以便查验腔体位置的确切信息。这确保了Okmetic和客户流程的顺利集成。空腔的应用主要用于简化设备制造,它可以集成到设备的主动、被动或其他结构性元件中。这使得处理比标准BSOI硅片更复杂的结构成为可能。这些空腔还可用于IC和MEMS工艺的集成,进一步增加了使用可能性。与标准体硅相同,Okmetic使用相同的质量和洁净度标准制造 C-SOI®硅片。
与其说是硅片,C-SOI®硅片可以被视为一种传感器结构,它是MEMS的最佳平台
C-SOI®硅片不仅仅是硅片,事实上它可以被视为一种传感器件或电子元件,其先进的技术可以实现更精简的MEMS生产工艺。这就是C-SOI®硅片作为MEMS和传感器设备的平台在过去十年稳步增长并在近几年迅速飙升的原因之一。
所需的膜厚度因不同的应用而异
Okmetic的高科技腔体SOI工艺能够制造极薄和极厚的膜,从而扩展器件设计和加工的多样性。带有薄膜的Okmetic的腔体SOI硅片被广泛应用于压力传感器、硅基扬声器和超声波换能器等,如PMUT和CMUT。具有较厚膜的腔体SOI硅片适用于惯性传感器(陀螺仪、加速度计、IMU等)、微镜和其他光学设备(如光开关等)。根据设计,薄膜或厚膜均可用于微流体设备,譬如喷墨头、计时设备和其他谐振器以及IC和MEMS工艺集成。此外,SOI硅片的使用也扩展到了射频滤波器件,为此Okmetic开发了高阻BSOI和C-SOI®硅片。
C-SOI®硅片的规格
下表列出了Okmetic的常规C-SOI®硅片的规格。我们的C-SOI®硅片通常都是为客户量身定制的,欢迎联系我们的销售和技术支持以获取更多详细资讯。
| C-SOI®硅片直径 | 200 mm, 150 mm |
器件层规格
| 晶体生长方式 | Cz, MCz, A-MCz® |
| 晶向 | <100>, <110>, <111> |
| N型掺杂剂 | 锑、磷 |
| P型掺杂剂 | 硼 |
| 电阻率 | 从 <0.001到 >7000 欧姆-厘米* *电阻率范围因掺杂剂和晶向而异 |
| 器件层 / 薄膜厚度 | 2微米到 >200微米 |
| 器件层 / 薄膜厚度公差 | 通常 ±0.5微米,EC-SOI硅片中低至±0.2微米 |
埋氧层(BOX)规格
| 类型 | 热氧化物生长于底层硅片或器件层或同时 |
| 厚度 | 0.3微米到5微米,通常在0.5微米到2微米之间 |
衬底层规格
| 晶体生长方式 | Cz, MCz, A-MCz® |
| 晶向 | <100>, <110>, <111> |
| N型掺杂剂 | 锑、磷 |
| P型掺杂剂 | 硼 |
| 电阻率 | 从 <0.001到 >7000欧姆-厘米* *电阻率范围因掺杂剂和晶向而异 |
| 衬底层厚度 | 200 mm:380-675微米 150 mm:380-725微米 |
| 衬底层厚度公差 | ±5微米 |
| 背面 | 抛光或氧化物蚀刻 |
腔体规格
| 空腔位置 | 衬底层或器件层,或埋氧层 |
| 腔体深度(硅体中) | 2 – 500微米 |
| 最小CD | 2微米 |
| 最大腔体跨度长度和薄膜厚度 | 采用标准C-SOI®工艺,<40:1微米 |
上表面对齐标记
| 对准精度,埋腔到上表面对准标记 | ±1微米 |
| 标记设计 | 根据客户工具特定 |
C-SOI®硅片优化 MEMS 制造工艺
和体硅微加工甚至传统的SOI技术相比,C-SOI®硅片有以下优势:更具成本效益和更精简的MEMS制造工艺,以及有益于制造更复杂、更先进、性能更好的设备。
C-SOI®硅片是一种先进的硅基衬底解决方案:
- 有利于减少成本、缩小设备尺寸
- 改进设备性能和精度
- 提高设备可靠性
- 更先进的设备设计
- 优化设备生产工艺——降低成本且更快上市
更先进的设计、卓越的性能和精度
Okmetic的图案化和蚀刻工艺具有一流的蚀刻均匀性。Okmetic能够生产具有极薄和厚膜的C-SOI®硅片、定义明确的水平尺寸以及灵活调整释放结构和基板之间间隙,从而有益于实现更先进的器件设计。腔体SOI硅片还可以通过最小化寄生电容来优化效率和电气特性。此外,通过集成背面封装和气密密封也可更好地实现工艺优化。
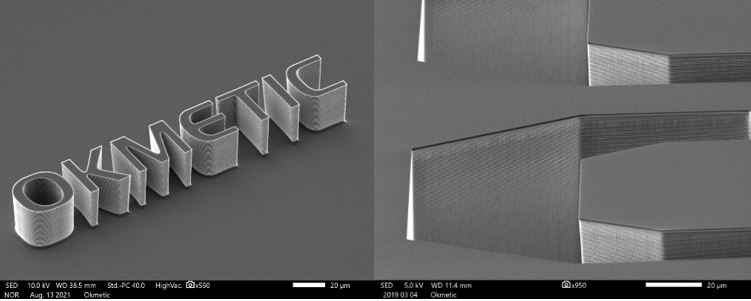
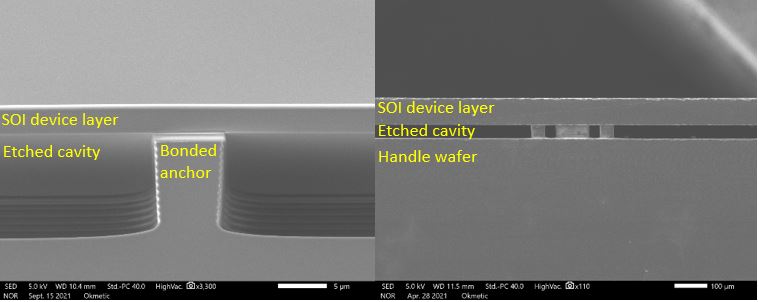
量身定制的腔体SOI解决方案:周期时间更短、品质更好
定制的C-SOI®硅片可无缝匹配客户的设备设计和工艺。从晶体生长阶段开始,整个制造过程都会考虑客户的设备设计。
C-SOI®硅片的整体设计和加工能有效提高硅片的品质和可靠性,并优化MEMS的生产工艺
自2015年以来,Okmetic一直在生产腔体SOI 硅片。Okmetic 的图案化和DRIE腔体蚀刻工艺完全是自主的工艺,大大缩短了腔体SOI硅片的产线周期——无需将硅片运送给客户进行腔体蚀刻,然后再返回到Okmetic进行键合加工。不过最重要的是,这种C-SOI®硅片的整体设计和加工方式提高了硅片的质量和可靠性,有助于优化MEMS生产工艺。详细了解Okmetic的图案化和腔体蚀刻工艺以及定制硅片。
成本效益优于体硅MEMS和传统的SOI技术
C-SOI®硅片提供了比体硅微加工甚至BSOI硅片更具成本效益的解决方案。譬如,在400微米厚的硅片上制造压力传感器时,与体硅微加工相比,每个芯片的成本可降低50%,与BSOI硅片相比可降低25%。这是因为C-SOI®硅片价格中包含图案化、蚀刻和键合成本,并且使用更先进的C-SOI®硅片时器件尺寸能够更小。
满足特种需求的C-SOI®硅片种类
EC-SOI硅片

Okmetic的EC-SOI硅片结合了最先进的硅技术(如高度均匀的E-SOI®硅片)和C-SOI®硅片的嵌入式腔体结构。EC-SOI硅片是一种新型的基板,它为先进的MEMS器件(如硅光子集成电路(PIC)和超声波换能器)、PMUT和CMUT开辟了新的可能性。
双层C-SOI®硅片

Okmetic的双层C-SOI®硅片将两个器件、埋氧层和衬底层的空腔相结合。这种组合已被论证为MEMS和光子设备带来了附加价值。
带图案化器件层的C-SOI®硅片

C-SOI®硅片的空腔在器件层上,而非衬底层上。详细了解我们的图案化工艺。
带多通孔的C-SOI®硅片

C-SOI®硅片通过埋入式氧化物通孔在器件和衬底层之间形成电气无隔离接触。可用于器件层接地。