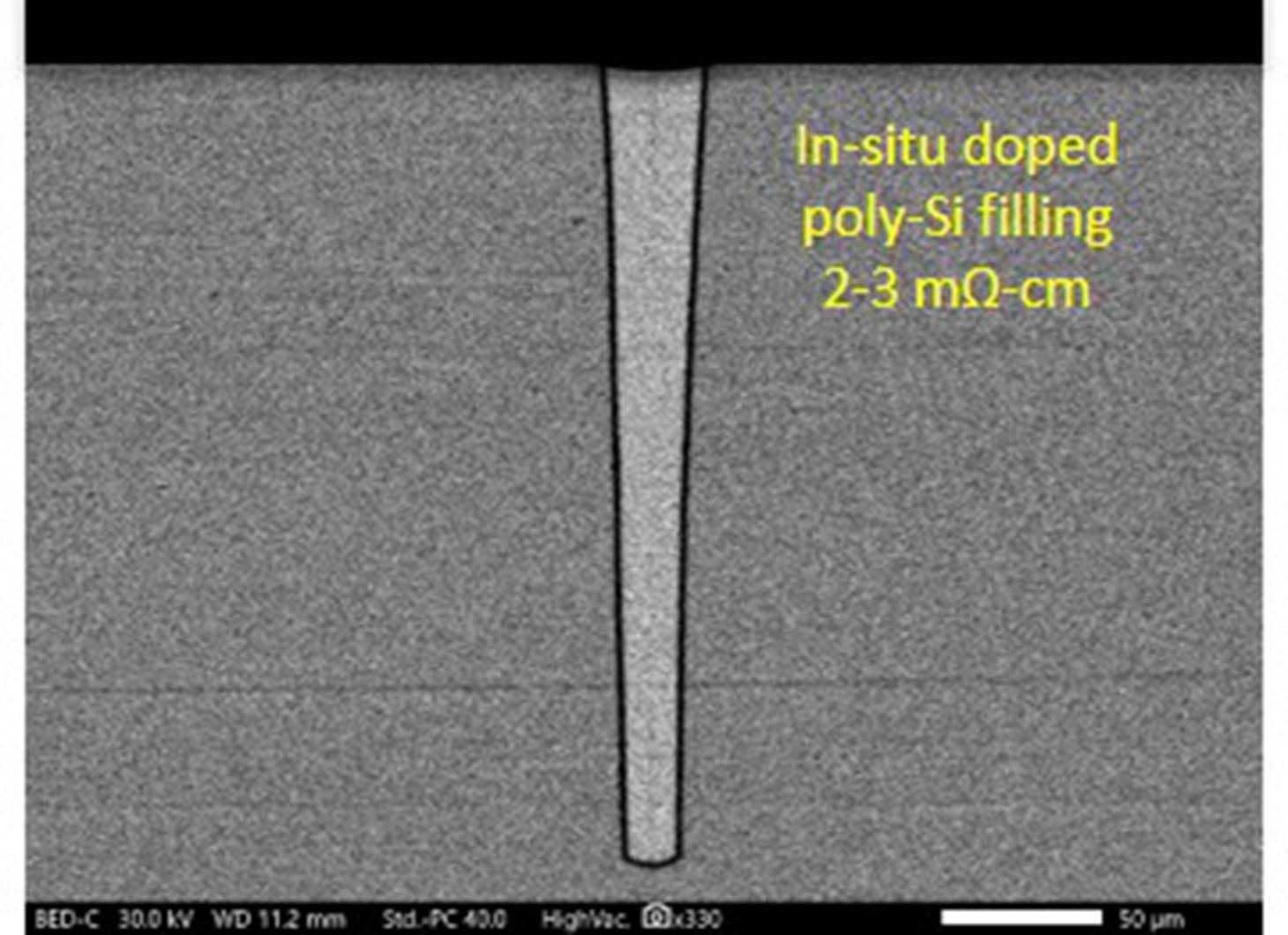
TSV-kiekot – Through Silicon Via
Okmeticin TSV-kiekot eristetyillä polypiiläpivienneillä mahdollistavat 3D MEMS -integraation ja paketoinnin. Sähköiset läpiviennit plasmasyövytetään DSP-kiekkoihimme ja täytetään voimakkaasti seostetulla polypiillä. Sopimusvalmistaja voi aukaista läpiviennit myöhemmin omassa prosessissaan käyttämällä esimerkiksi kiekon hiontaa tai muuta ohennusprosessia.
Okmeticin polypiillä täytetyt Through Silicon Vias -läpiviennit (TSV) mahdollistavat eristettyjen sähköisten läpivientien valmistamisen piikiekkoon, mikä auttaa pienentämään MEMS-komponenttien kokoa ja mahdollistaa kerrosten väliset sähköiset yhteydet ja 3D MEMS -integraation. Piikiekkojamme läpivienneillä käytetään pii-interposereina ja kansituksessa erilaisissa anturisovelluksissa kuten resonaattoreissa ja inertia-antureissa.
Okmeticin TSV-kiekot auttavat pienentämään MEMS-komponenttien kokoa ja mahdollistavat kerrosten väliset sähköiset yhteydet ja 3D MEMS -integraation.
Okmeticin läpiviennit valmistetaan syövyttämällä ne kaksipuolisesti kiillotettuun DSP-kiekkoon Via-First-menetelmällä. Läpivientien eristeenä käytetään termistä oksidia ja johtavana materiaalina boorilla in-situ seostettua polypiitä. Tällä tavalla läpiviennit integroidaan kiekkoon heti kiekonvalmistuksen jälkeen ja sovellusvalmistajien tarvitsee vain paljastaa ne taustahionnalla tai jollain muulla kiekon ohennusmenetelmällä myöhäisemmässä prosessivaiheessa. DSP-kiekot läpivienneillä voidaan yhdistää myös SOI-alustoihin. Asiakkaat voivat liittää TSV-kiekot muihin kiekkoihin yleisesti käytetyillä bondausmenetelmillä (anodinen, metalli tai lasisulatesidos).
TSV-kiekkojen ja C-SOI® -kiekkojen yhdistelmä
Vertikaalisia läpivientejä tarvitaan, jotta voidaan käyttää tavanomaista flip-chip-bondausta antureiden pakkaamiseksi suoraan kiekolle. Edistyneissä MEMS-valmistusprosesseissa C-SOI®-kiekot onkalorakenteineen yhdistetään TSV-kiekkoihin bondaamalla. Tämä mahdollistaa huomattavasti yksinkertaisemman pakkauksen ja jopa sirujen integraation. Lopputuloksena on pienempi komponenttikoko ja kustannustehokas standardoitu prosessi CAP-suojausta varten.
TSV-kiekkojen avulla pienempi komponenttikoko ja yksinkertaisempi prosessi-integraatio
Okmeticin TSV-kiekot polypiitäytteisillä läpivienneillä ovat yhteensopivia korkean lämpötilan prosessien kanssa, ja kiekkojen puhtaus vastaa täysin CMOS-valmistuksen standardeja. Poly-läpiviennit ovat kestäviä ja helposti integroitavissa, sillä ne sisältävät ainoastaan piitä ja termistä piidioksidia, joiden materiaaliominaisuudet tunnetaan hyvin. Asiakkaat voivat käyttää hyvin tunnettuja metallisia yhteyksiä ja juotenystyjä luodakseen elektronisia yhteyksiä poly-TSV-läpivienteihin bondauksen ja ohennuksen jälkeen. Poly-TSV-läpivientien suorituskyky MEMS-sovelluksissa on todistetusti erinomainen niiden yhtenäisen resistiivisyyden sekä läpiviennin matalan vastuksen ja kapasitanssin vuoksi.
MEMS-sovelluksissa todennettu suorituskyky:
- Resistiivisyyden yhtenäisyys <5% kiekosta toiseen tai saman kiekon välillä
- Vastus 10-15 Ohm (30 µm halkaisija, 200 µm syvyys)
- Kapasitanssi <0.5 pF (2 µm terminen oksidi -eristys)
- Vuotovirta <0.5 pA@100 V (2 µm terminen oksidi)
TSV-kiekkojen design räätälöidään tarpeisiinne

Okmeticin läpiviennit syövytetään kaksipuolisesti kiillotetulle DSP-kiekolle, joilla on erinomainen tasomaisuus, orientaatiotarkkuus sekä ensiluokkainen ja tasainen kidelaatu. Kokenut myynti- ja asiakastukitiimimme keskustelee mielellään kanssanne TSV-kiekkoparametreistä kuten kiekon paksuudesta, läpivientien ulottuvuuksista, kaltevuudesta, resistiivisyydestä, kapasitanssista, layoutista ja eristysresistanssista ja auttavat löytämään tarpeisiinne sopivan vaihtoehdon.
TSV-kiekkoina käytettävien DSP-kiekkojen spesifikaatiot
| Kasvatusmenetelmä | Cz, MCz, A-MCz® |
| Halkaisija | 150 mm, 200 mm |
| Kideorientaatio | <100>, <110>,<111>, kallistettu orientaatio |
| N-tyypin seosaineet | Antimoni, Fosfori |
| P-tyypin seosaineet | Boori |
| Resistiivisyys | <0,001 ja >7000 Ohm-cm välillä* *Resistiivisyysvalikoima vaihtelee seosaineen ja orientaation mukaan |
| Paksuus | 670 ja >1000 µm välillä |
| Paksuustoleranssi | ±5 µm |
TSV-läpivientien määritelmät
| Leveys | 7-30 µm |
| Pituus | >2x leveys |
| Syvyys | <250 µm |
| Kuviosuhde | <10 |
| Läpivientien tiheys | <20 läpivientiä/mm2 |
| Eristävän oksidin paksuus | 0.5…2.0 µm |
| Läpiviennin kovertuma (dishing) | <0,5 µm |
| Läpiviennin resistiivisyys | <5 mOhm-cm (Boorilla seostettu in-situ polypii) |