
功率分立器件硅片
Okmetic的功率分立器件硅片可提供<0.001至>1500欧姆-厘米的可定制化电阻率、受控的电阻率分布、优化的氧浓度和低缺陷密度。MCz和A-MCz®长晶法以及多种硅片参数选择确保了定制化高附加值的硅片解决方案,同时提高了产量和击穿电压。
数十年来,Okmetic一直是值得信赖的功率分立器件晶圆供应商,自20世纪90年代以来就在汽车行业站稳了脚跟。我们在晶体生长技术方面拥有深厚的专业知识,同时拥有供应大批量定制化硅片解决方案的能力,再再彰显出我们在该领域的突出地位。
客户对于200mm硅片提出了更严格的要求,这不仅因为功率器件的复杂性提高了,同时也因为预期行业逐渐转向300mm Cz法(Czochralski)制备的硅片。Okmetic的功率分立器件硅片具有可定制化的电阻率、严格管控的电阻率变化、微调的氧浓度和低缺陷密度,可实现性能极高的功率分立器件,并提高其产量。在最大限度地减少影响功率器件击穿电压的晶体缺陷方面,Okmetic拥有丰富的专业知识。我们的硅片经过精心设计,不会产生位错和滑移,能够提供可选的COP水平管理,可增强栅极氧化物完整性(GOI)。了解Okmetic的低COP硅片的更多信息。
功率分立器件硅片经过精心设计,不会产生位错和滑移,能够提供可选的COP水平管理,可增强栅极氧化物的完整性。
Okmetic的功率分立器件硅片可作为非穿通型(NPT)/场截止型(FS)IGBT应用中区熔硅片的直接替代品,或作为颇具挑战性的外延沉积的衬底,被广泛应用于穿通型(PT)IGBT、功率MOSFET、高压二极管、快恢复二极管(FRD)、肖特基二极管(SBD)、晶闸管、功率双极结型晶体管(BJT)和其他双极器件等。

区熔法硅片的替代品,实现经济高效且保证其高性能
新的磁拉法(MCz)长晶工艺使Cz法的硅片成为优于区熔法(FZ)硅片的首选衬底。采用MCz和A-MCz®长晶法生长的Okmetic功率分立器件硅片适用于先进的NPT/FS IGBT器件,为客户提供了优于区熔硅片的更经济高效的替代方案。通过优化氧浓度、限制电阻率分布并增强栅极氧化物完整性(GOI),我们能够解决与直拉法相关的常见问题。
采用MCz和A-MCz®长晶法生长的Okmetic功率分立器件硅片适用于先进的NPT/FS IGBT器件,为客户提供了优于区熔法硅片的更经济高效的替代方案。
优化的氧浓度
使用A-MCz®长晶法可以在大批量生产中保证可重复的低氧浓度(Oi)水平。低Oi水平(<5.5 ppma)可最大限度地减少热供体(TD)问题并抑制体微缺陷(BMD)。此外,优化的氧含量可减少氧碳复合物的形成,这种复合物会在IGBT退火和高能注入工艺过程中导致缺陷。为了确保热供体的稳健性,所有晶圆都经过TD-kill工艺。低Oi的硅片不会因高氧浓度而产生缺陷,但仍受益于氧的强化效应。与区熔硅片相比,这提高了滑移和辐射的稳健性。
低Oi水平(<5.5 ppma)可最大限度地减少热供体(TD)问题并抑制体微缺陷(BMD)。

受控的电阻率分布
功率分立器件硅片在整个晶圆上表现出出色的电阻率均匀性,径向电阻率梯度(RRG)通常低于8%。Okmetic在制造更高电阻率硅片(1500欧姆-厘米或更高)方面拥有丰富的经验,可以满足最苛刻的功率器件的需求。电阻率容差是根据价格目标和所需电阻率范围确定的。

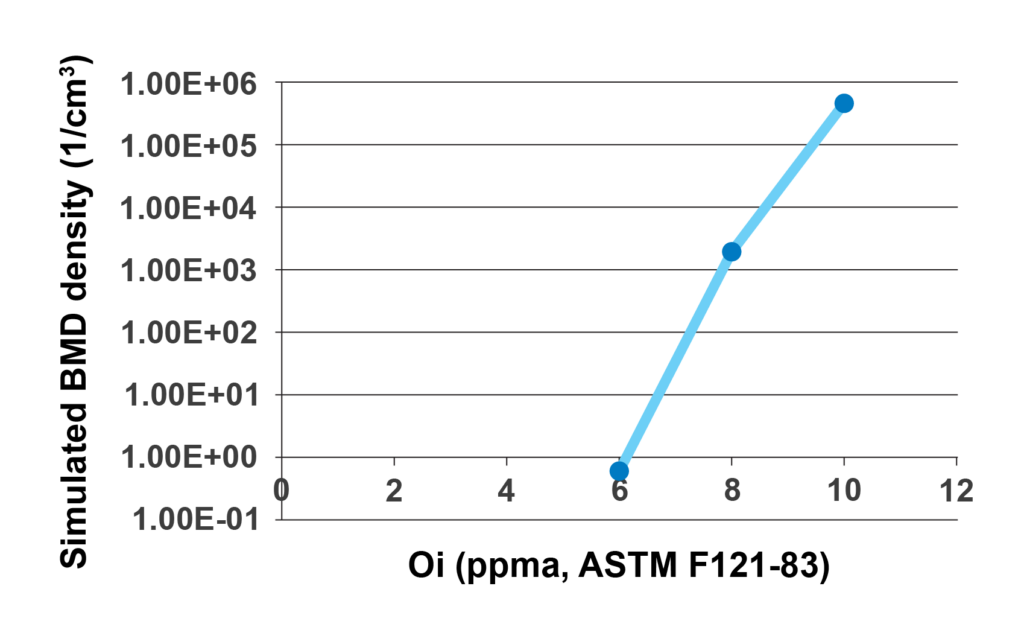
增强GOI的性能
Okmetic能够提供低COP的功能,以增强栅极氧化物完整性(GOI)的性能。将低COP的选项和BMD优化的低氧含量A-MCz®长晶技术相结合,可以进一步增强GOI的性能。
将低COP的选项和BMD优化的低氧含量A-MCz®长晶技术相结合,可以进一步增强GOI的性能。
用于高品质外延的定制化外延衬底
大批量生产的定制化硅片是我们的核心业务。我们专注于定制硅片参数,以满足最苛刻的功率器件的需求。电阻率可以从非常低到非常高进行定制,范围从0.001到>1500欧姆-厘米,同时晶圆厚度可以根据客户的工艺进行定制,范围从380到1150微米。此外,Okmetic的图案化工艺可以实现超级结和其他新型的沟槽结构。
在用于防止自动掺杂的LTO背封和用于有效吸杂的Polyback密封方面,Okmetic的产品表现出色。我们同时也提供LTO和多晶硅堆叠的各种组合,包括多晶硅-LTO-多晶硅的超级密封,以减轻结节和边缘相关的外延问题。我们的客户支持可以为您介绍我们为硅片翘曲/弯曲和电阻率窗口优化问题提供的不同方案,以确保无失配的外延层和可预测的掺杂剂/金属扩散行为。此外,我们还能够优化晶圆边缘,以满足最苛刻的工艺需求,譬如硅片减薄和超厚外延沉积等问题。
我们同时也提供LTO和多晶硅堆叠的各种组合,包括多晶硅-LTO-多晶硅的超级密封,以减轻结节和边缘相关的外延问题。
功率分立器件硅片规格
| 长晶方式 | Cz, MCz, A-MCz® |
| 直径 | 200 mm, 150 mm |
| 晶向 | <100>,<110>,<111> |
| N型掺杂剂 | 锑、砷、磷 、红磷 |
| P型掺杂剂 | 硼 |
| 电阻率1 | <0.001至>1500欧姆-厘米 |
| 电阻率容差 | 根据价格目标和电阻率范围确定 |
| 径向电阻率梯度 (RRG)2 | 通常低于8% |
| 氧浓度 (Oi)3 | <4至20 ppma |
| 径向氧梯度 (ROG)4 | 通常低于10% |
| 碳浓度5 | <0.5 ppma |
| 单抛片厚度6 | 200 mm:550至1150微米 150 mm:400至1150微米 |
| 双抛片厚度6 | 200 mm:380至1150微米 150 mm:380至>1150微米 |
| 单抛片背面处理 | 蚀刻、LTO背封层结构、Polyback |
| COP含量7 | 标准或低COP(取决于硅片大小和电阻率) |
2SEMI MF84,取决于电阻率目标和边缘排除
3ASTM F121-831/SEMI MF1188-1107
4SEMI MF951, 低氧浓度:ROG >20%
5ASTM F123-91,受测量技术限制
6在一定限制条件下可实现其他厚度
7一定条件下能够提供低COP版本的200mm硅片
完全兼容CMOS硅片表面质量和清洁度要求